

|
Новая технология микроскопии облегчит разработку и обеспечит контроль производства трехмерных полупроводниковых чипов
Ученые из Национального института стандартов и технологий (National Institute of Standards and Technology, NIST) модернизировали разработанную ими несколько лет назад технологию оптической микроскопии и приспособили ее для обеспечения обзора наноразмерных объектов, что позволяет произвести контроль производства элементов трехмерных полупроводниковых чипов нового поколения. С помощью этой технологии, называемой TSOM (Through-Focus Scanning Optical Microscopy), можно не только рассмотреть наноразмерные компоненты чипов, которые до недавнего времени были двухмерными конструкциями, но и с достаточно высокой точностью определить различия в их формах и размерах, что и требуется для проведения технологического контроля.
Новые поколения полупроводниковых чипов имеют в своем составе трехмерные элементы, которые накладываются друг на друга. Для правильной и надежной работы чипа в целом требуется, чтобы все компоненты имели правильные формы и строго заданные габариты. Существующие методы микроскопии, электронной, атомно-силовой и другие, могут обеспечить контроль формы и размеров элементов чипа, но сделают это крайне медленно, с риском нанести повреждения хрупкой структуре чипа и стоят крайне дорого. А использование оптических методов микроскопии ограничивается тем, что размеры элементов чипов намного меньше половины длины волны света видимого диапазона (250 нанометров для зеленого света), поэтому оптический микроскоп физически не может увидеть столь маленькие объекты.
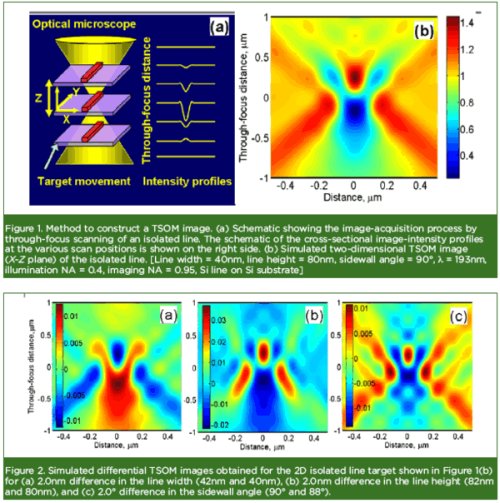 Технология TSOM позволяет увидеть оптическим способом объекты, размеры которых приблизительно равны 10 нанометрам, а в перспективе и еще меньше. В методе TSOM используется обычный оптический микроскоп, который делает не один, а множество расфокусированных двухмерных снимков интересующего объекта с нескольких точек зрения. Используя изменения яркости с этих расфокусированных снимков компьютер вычисляет градиенты света и определяет границы снимаемых объектов, создавая таким образом результирующее трехмерное изображение. Изображения, получаемые с помощью метода TSOM несколько абстрактны, но детали, которые на них видны, позволяют с достаточно высокой точностью определить различия в формах и размерах компонентов полупроводниковых чипов. "Наши исследования показали, что с помощью метода TSOM мы можем рассмотреть элементы, размерами около 10 нанометров, чего вполне достаточно для обеспечения контроля технологических процессов производства полупроводников на ближайшее десятилетие" - рассказывает Рэвикирэн Аттота (Ravikiran Attota), ученый из NIST, - "Кроме этого, технологию TSOM можно будет использовать не только в электронной промышленности, но и в других отраслях промышленности, в науке и везде там, где требуется производить анализ и контроль форм крошечных трехмерных объектов".
Страница сайта http://www.silicontaiga.ru
Оригинал находится по адресу http://www.silicontaiga.ru/home.asp?artId=11994 |